热考虑因素
CSD88584Q5DC 功率模块器件能够利用 PCB 铜平面作为主要热路径。因此,在封装中使用热过孔是将热量从器件吸收到系统电路板的有效方法。关于焊锡空洞和制造问题的担忧可以通过使用三种基本策略来解决,以最大限度地减少沿过孔筒壁向下吸走的焊锡量:
故意将过孔相互间隔开,以避免在特定区域内出现孔洞聚集。
使用设计允许的最小钻孔尺寸。下图中示例使用了 10-mil 钻孔和 16-mil 焊盘的过孔。
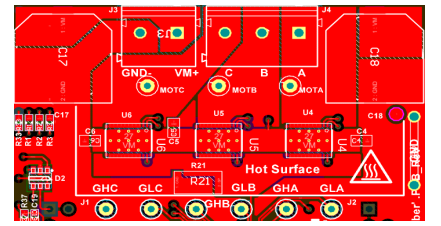
在过孔的另一侧使用阻焊层遮盖( Tent)。最终,热过孔的数量和钻孔尺寸应与最终用户的 PCB 设计规则和制造能力保持一致。
为了利用 DualCool 热增强型封装,可以在功率模块器件顶部安装外部散热器。为了降低 EMI,散热器通常通过安装螺丝连接到 PCB 上的 GND。在封装顶部和散热器之间应使用具有良好导热性的间隙垫绝缘体。推荐使用 Bergquist Sil-Pad 980,它在 50 psi 下提供 1.07°C/W 的优异热阻。