管芯应直接通过共晶或导电环氧树脂连接到接地平面(见HMC一般处理、安装、粘合说明)。
建议在0.127mm(5 mil)厚的氧化铝薄膜基板上使用50欧姆微带传输线,用于将射频引入和引出芯片(图1)。如果必须使用0.254mm(10密耳)厚的氧化铝薄膜基板,则应将模具抬高0.150mm(6密耳),使模具表面与基板表面共面。实现这一点的一种方法是将0.102mm(4密耳)厚的芯片连接到0.150mm(6密耳)宽的钼散热器(钼片)上,然后将其连接到接地平面(图2)。
微带基板应尽可能靠近管芯,以尽量减少带状键合长度。典型的芯片到基板间距为0.076mm(3密耳)。建议使用0.075毫米(3密耳)宽、最小长度<0.31毫米(<12密耳)的金带,以尽量减少RF、LO和IF端口上的电感。
Vdd输入端应使用RF旁路电容器。建议使用距离芯片不超过0.762mm(30mils)的100pF单层电容器(共晶或导电环氧树脂安装)。
安装
芯片背面金属化,可以用AuSn共晶预成型件或导电环氧树脂进行芯片安装。安装表面应清洁平整。
共晶模具连接:建议使用80/20金/锡预成型件,工作表面温度为255摄氏度,工具温度为265摄氏度。当施加热90/10氮气/氢气时,工具尖端温度应为290摄氏度。不要将芯片暴露在高于320摄氏度的温度下超过20秒。连接时不需要超过3秒的擦洗。
环氧树脂芯片连接:在安装表面涂上最少量的环氧树脂,以便在芯片放置到位后,在芯片周围观察到薄的环氧树脂圆角。按照制造商的计划固化环氧树脂。
引线键合
使用直径为0.025mm(1 mil)的纯金线进行球形或楔形键合。建议使用标称阶段温度为150摄氏度、球键合力为40至50克或楔形键合力为18至22克的热超声引线键合。使用最低水平的超声波能量来实现可靠的引线键合。接线应从芯片上开始,在封装或基板上终止。所有粘合应尽可能短<0.31mm(12密耳)。
操作注意事项
遵循这些预防措施以避免永久性损坏。
储存:所有裸片都放在华夫格或凝胶基ESD保护容器中,然后密封在ESD保护袋中运输。一旦打开密封的ESD保护袋,所有模具应存放在干燥的氮气环境中。
清洁:在清洁的环境中处理芯片。请勿尝试使用液体清洁系统清洁芯片。
储存:所有裸片都放在华夫格或凝胶基ESD保护容器中,然后密封在ESD保护袋中运输。一旦打开密封的ESD保护袋,所有模具应存放在干燥的氮气环境中。
静电灵敏度:遵循ESD预防措施,防止>±250V ESD电击。
瞬态:在施加偏压时抑制仪器和偏压电源瞬态。使用屏蔽信号和偏置电缆,以尽量减少电感拾取。
一般处理:用真空夹头或锋利的弯曲镊子沿边缘处理芯片。芯片表面有脆弱的气桥,不应使用真空夹头、镊子或手指触摸。
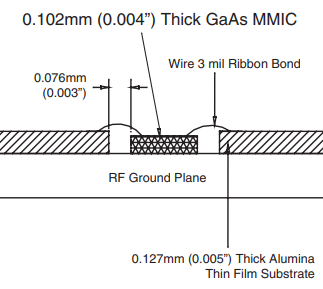
图1
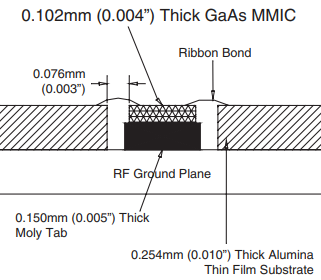
图2